晶圆级先进封装技术是各大封测厂商技术必争目标
今年SEMICON上海展N5馆中国大陆三大封测厂及晶方科技皆有参展,各大封测厂的展示重点主要是显现企业自身所具备的封装技术的多样性及完整性,尤其凸显晶圆级封装技术及SiP技术,具备晶圆级先进封装量产能力成为专业IC封测代工业者(OSAT)的技术竞争目标,而具备SiP封装技术则体现对潜在客户的客制化能力。
从技术特点上来看,晶圆级封装技术可分为FIWLP(Fan-In WLP扇入型晶圆级封装)、FOWLP(Fan-Out WLP扇出型晶圆级封装)两种,相对于FI,FO可不受芯片面积的限制,将I/O bumping通过RDL层扩展至IC芯片周边,在满足I/O数增大的前提下又不至于使Ball pitch过于缩小。
图表1 FIWLP与FOWLP示意图

资料来源:集邦咨询,2019.04
目前晶圆级封装约占整个先进封装(主要包括Flip Chip、Embedded Die in Substrate、FIWLP、FOWLP、2.5D/3D)20%的份额,扇入型封装器件主要为WiFi/BT集成组件、收发器、PMIC和DC/DC转换器,全球主要参与者日月光、矽品、长电科技、德州仪器、安靠、台积电约占全球FIWLP 60%的份额。而扇出型封装可分为低密度扇出型封装(小于500个I/O、超过8um的线宽线距)及高密度扇出型封装,其中低密度扇出型封装主要用于基频处理器、电源管理芯片、射频收发器,高密度扇出型封装主要用于AP、存储器等具备大量I/O接脚的芯片。相对而言,扇出型晶圆级封装的参与者较少,长电科技、台积电、安靠、日月光约占全球85%的份额。
值得一提的是,扇出型封装新进玩家华天科技继推出自有IP特色的eSiFO技术后,于今年的SEMICON China新技术发布会上推出了eSinC(埋入集成系统级芯片,Embedded System in Chip)技术。eSinC技术同样采用在硅基板上刻蚀形成凹槽,将不同芯片或元器件放入凹槽中,通过高密度RDL将芯片互连,形成扇出的I/O后制作via last TSV实现垂直互连。eSinC可以将不同功能、不同种类和不同尺寸的器件实现3D方向高密度集成。
图表2 华天科技eSinC示意图

资料来源:华天科技,集邦咨询,2019.04
随着未来电子产品高性能、小尺寸、高可靠性、超低功耗的要求越来越高,晶圆级封装凭借固有的、无可比拟的最小封装尺寸和低成本(无需载板)相结合的优势,将驱使晶圆级封装技术应用到更多的新兴的细分市场,比如5G毫米波器件、MEMS、ADAS汽车应用等领域。
1)具有前道工艺的代工厂在先进封装技术研发方面具有技术、人才和资源优势,因此在高密度扇出型集成(尤其在3D集成)方面将来还是以Foundry厂主导,台积电将是主要的引领者;
2)在扇入型及低密度扇出型方面主要以OSAT、IDM为主,而且随着时间的推移,进入的OSAT厂将越来越多,各企业将展开差异化竞争;
3)为了进一步降低封装成本,不少厂商在做panel-based研发,预计两年后的SEMICON China将出现panel-based技术的发布。
先进封装有望带动国产设备进一步提高国产率
本次SEMICON China有关封装设备的展览中,传统封装设备以国际大厂设备为主,而在先进封装领域则中国厂商展览数目较多,包括北方华创、上海微电子、中微半导体、盛美半导体等,其中北方华创可为Flip Chip Bumping、FI、FO等封装技术提供UBM/RDL PVD以及为2.5D/3D封装提供高深宽比TSV刻蚀、TSV PVD工艺设备;上海微电子展示用于先进封装的500系列步进投影光刻机;盛美半导体则发布了先进封装抛铜设备和先进封装电镀铜设备。
先进封装生产过程中将用到光刻机、蚀刻机、溅射设备等前道设备,但是相对于前道制造设备,先进封装所用设备的精度、分辨率等要求相对较低,以光刻机为例,上海微电子用于先进封装所用步进光刻机分辨率约为其用于前段制造光刻机分辨率的十分之一。
根据集邦咨询统计,2018年中国先进封装销售额为179.2亿元,约占2018年中国封测总销售额的8.9%,远低于全球先进封装比例30%,未来中国先进封装的成长空间巨大,中国设备厂商在不断研发前段设备的同时,切入精度、分辨率较低的后段设备,是带动国产设备进一步提升国产率的一大机遇。
图表3 扇出型晶圆级封装所用设备及主要厂商
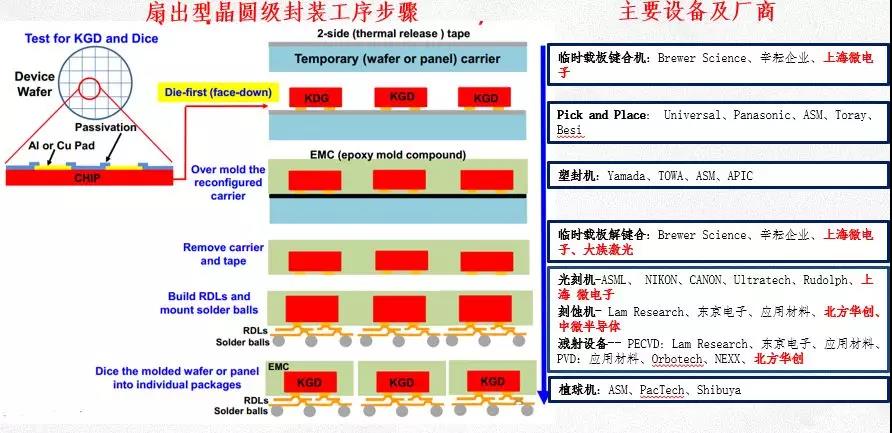
资料来源:集邦咨询,2019.04
国产测试机设备厂暂难以在AI、5G新兴产业相关主题中分一杯羹
在本次展会上,国际测试机龙头企业爱德万(Advantest)、泰瑞达(Teradyne)推出在AI、5G等新兴产业中先进的测试解决方案,其中爱德万V93000可扩充式平台,具备每脚位1.6Gbps快速的资料传输速率、主动式温度控制(ATC)等功能,采用最新IC测试解决方案和服务来支持AI技术;而Teradyne重点推出的适用于AI及5G测试机US60G可达60Gbps串行接口测试。
目前全球集成电路FT测试机主要掌握在美日厂商手中,美国泰瑞达、科休和日本爱德万约占全球FT测试设备80%市场份额。中国本土企业如长川科技、北京华峰测控虽通过多年的研究和积累,在模拟/数模测试和分立器件测试领域已经开始实现进口替代,但在SoC和存储等对测试要求较高的领域尚未形成成熟的产品和市场突破,基本只用于中国本土封测厂中低端测试领域。
如今在AI、5G等新兴产业下,芯片集成度更高、测试机模块更多,国际寡头凭借技术优势、人才优势、市场优势,大有强者恒强的趋势。同时由于在SoC芯片测试领域涉及到算法、硬件设计、结构设计等多个领域技术的综合运用,在单一平台上实现多功能的全面综合测试且有效控制测试时间,存在非常高的技术壁垒,本土企业起步较晚,需要通过自主创新进行整体系统研发,在高端测试领域实现国产化道路远阻。